本文来自微信公众号“电子发烧友网”,作者/黄晶晶。
日前,台积电举办了2024年第二季度业绩的法说会。释出不少动态引发业界关注,除了高性能计算代工业务带动营收高速增长之外,更是首次提供晶圆代工2.0,借由更广泛的业务尤其是先进封测技术,以期推动台积电进入下一个业务扩张的阶段。
晶圆代工2.0的机会
在日前台积电2024年第二季度业绩的法说会上,台积电董事长兼总裁魏哲家提出了“晶圆代工2.0”概念。他指出,“晶圆代工2.0”不仅包括传统的晶圆制造,还涵盖了封装、测试、光罩制作等环节,以及IDM(不包括存储芯片)。
台积电财务长黄仁昭进一步解释称,“晶圆制造2.0”的提出是为了适应IDM厂商介入代工市场的趋势,晶圆代工的界线逐渐模糊,因此扩大了定义。但台积电将专注于最先进后段封测技术,以帮助客户制造前瞻性产品。
若按照“晶圆代工2.0”定义来算,台积电表示2023年晶圆制造产值接近2500亿美元,旧定义为1150亿美元左右。而台积电2023年晶圆代工业务市占率只有28%。但台积电在2023年已经拿下全球芯片代工市场55%的份额,稳居全球第一。也就是说,按“晶圆代工2.0”定义,市场规模扩大了一倍。此外,在新定义下,预计2024年晶圆代工产业规模将继续增长10%。这么大的市场容量为台积电的营收成长扩充了非常多的空间。
Q2营收同比增长32.8%,7nm及以下营收占67%
截至2024年6月30日台积电第二季度营收为6735.1亿元新台币,净利润为2478.5亿元新台币。与去年同期相比,台积电第二季度营收增长40.1%,净利润和摊薄每股收益均增长36.3%。与2024年第一季度相比,第二季度营收增长13.6%,净利润增长9.9%。
以美元计算,第二季度营收为208.2亿美元,同比增长32.8%,环比增长10.3%。公告显示,台积电第二季度毛利率为53.2%,营业利润率为42.5%,净利润率为36.8%。
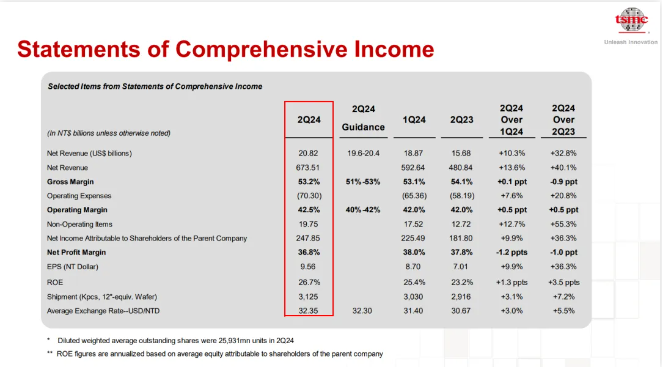
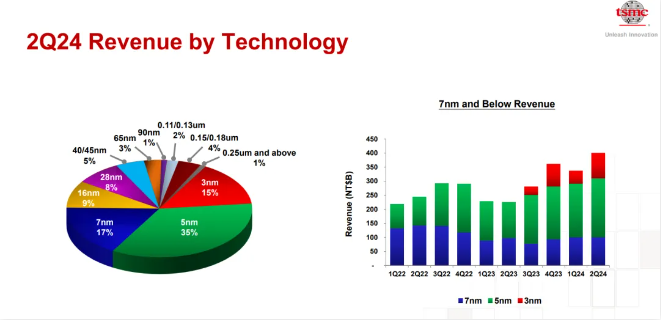
按制程来看,2024年第二季度,5nm营收占总收入的35%,为最大份额,3nm占15%,7nm占17%。7nm及以下先进制程技术营收的总占比为67%。二季度3nm营收较一季度增长显著。
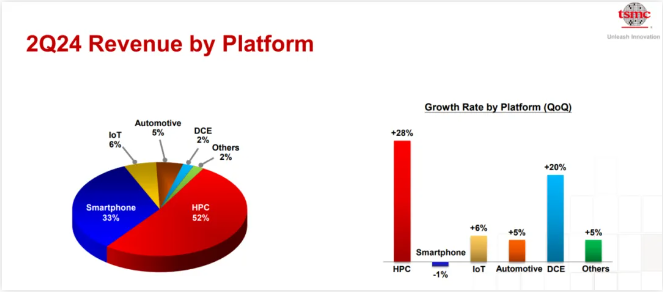
从应用平台营收来看,第二季度高性能计算(HPC)营收占比达52%,智能手机占比达33%,IOT仅6%,汽车仅5%,高性能计算的营收环比增长28%,DCE环比增长20%,IOT、汽车和其他业务均有小幅增长,仅有智能手机营收环比下降1%。
对于2024年第三季度的业务预期,台积电管理层希望收入在224亿至232亿美元之间(第二季度营收为208.2亿美元),毛利率将在53.5%至55.5%之间,营业利润率将在42.5%至44.5%之间。
资本支出方面,2024年资本支出小幅上调,从280亿美元至300亿美元调整为300亿美元至320亿美元。台积电表示资本支出是根据客户需求来投入,看好AI的长期需求增长。今年资本支出约70%~80%用在先进制程技术,10%~20%用在特殊制程技术,10%用在先进封装测试和掩模生产等。
台积电预期2nm流片数量早期会高于3nm、5nm,器件性能提升达到25~30%,芯片密度提升15%以上。推出N2P制程进一步优化能效,支持HPC、手机应用,N2P预计2026年H2量产。推出下一代技术SPR(super power rail),最佳的背板供电方案,保持密度和灵活性。与N2相比,相同功率性能提升10%,密度提升10%以上,在复杂信号场景有很大价值。
CoWoS的产能改善以及FOPLP封装预期
受益于AI相关的先进封装需求旺盛,包括英伟达H100、A100、AMD MI300等芯片都在使用台积电的CoWoS先进封装技术,CoWoS(Chip on Wafer onSubstrate)产能供不应求。魏哲家表示,当前产能很难满足客户需求,原先预计今年产能翻倍,但现在不止翻倍,甚至到明年估计也会翻倍不止。
至于CoWoS-S迁移到CoWoS-L/R等工艺版本,魏哲家表示这些都是基于客户的需求,即便同样的客户对不同产品也有不同的技术要求。台积电的CoWoS产能翻倍是不同版本加起来。同时,也需要和所有合作伙伴进行合作来支持客户,例如不同版本的CoWoS需要不同的tool set,即使一些tool可以被所有版本使用,但不同版本还是会有不同需求。
此外,过去先进封装的毛利率比台积电的平均毛利低一些,但现在已经开始接近,主要是因为规模效应、成本减少。而毛利率是不断增长的。
当前在业内FOPLP有望以更低成本、更大灵活性等优势成为先进封装的后起之秀。对于这一工艺,魏哲家表示台积电正推进扇出式面板级封装(FOPLP)工艺,目前已经成立了专门的研发团队和生产线,只是目前仍处于起步阶段,相关成果可能会在3年内问世。魏哲家还表示未来英伟达和AMD等HPC客户可能会采用下一代先进封装技术,用玻璃基板取代现有材料。
为AI刺激换机需求做准备等
在台积电第二季度财报发布前夕,一条有关特朗普提及半导体芯片产业以及台湾地区的访谈报道引发广泛关注。特朗普认为,由于美国全部的芯片业务“被抢夺”,且没有得到任何好处,台湾方面应当向其支付“防务费用”。受此影响,7月17日,台积电股价一度出现大跌。
而在法说会上,魏哲家也对此做出回应,他说,到现在为止,我们没有修改任何海外扩产计划,我们会继续在Arizona和日本扩产,未来可能在欧洲也会扩产。如果有关税提升,客户需要负责。
在AI PC、AI手机的推动下,客户都希望在端侧加入AI,增加die size。魏哲家表示,增加的幅度不同客户有所不同,总体来看10%的增长较为常见。我们期待AI功能将刺激换机周期的缩短,可能2年后会看到爆发,为此我们从现在到2026年都在努力扩产支持。
魏哲家还说到,我们的客户进入N2、A16,需要采用Chiplet方案以及先进封装。所有客户都希望迁移到更好能效的制程,降低功耗,尤其是HPC客户。未来几年我们都将努力支持这样的需求。

